
トップページ > 電気化学 測定 > ALS 電気化学 アナライザー
ALS920D SECM走査型電気化学顕微鏡

- 特長
- 測定原理
- 仕様
- テクニック一覧
- 応用例
- 付属品・オプション
- 電極表面研究
- 生体、細胞サンプル
- 半導体の表面分析
- 腐食研究
- 液界面間のイオン移動研究
- 膜特性研究
新しい電気化学の世界が広がる
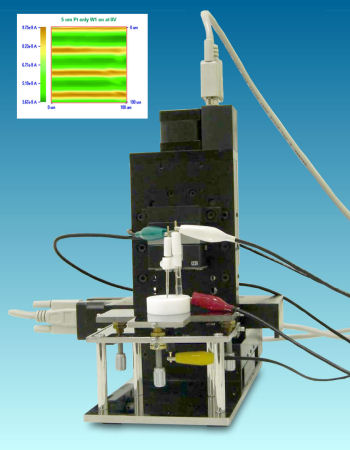
1989年に紹介された走査型電気化学顕微鏡(Scanning electro-chemical microscopy, SECM)は界面近傍の化学的な変化を高解像度で観察するための装置です。サンプル表面の近傍をスキャンして微小探針で起こる反応を画像化します。SECMは表面の化学物質の反応像、反応速度の定量を行なうために使用します。応用分野としては腐食研究、細胞膜の研究、液液界面の研究に用いられており、更に用途が広がってます。
探針を基板上の任意の高さに設定し、二次元方向に走査します。コンピューター制御にて走査位置、電気化学測定、データ解析を行うことができます。
SECMのプローブを用いてサンプル計測する原理を下記に示します。
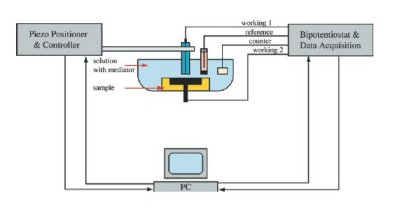

- A.探針を基板から遠ざけると、探針電流は定常状態になります。
- B.探針を絶縁基板に近づけると、Oの拡散が妨げられiT≤iT ∞
- C.探針が導電性基板に近づくと、Oのポジティブフィードバックにより、iT≥iT ∞
A、B、Cの電流応答を定量的に解析できます。基板表面の電気化学 反応をイメージできます。
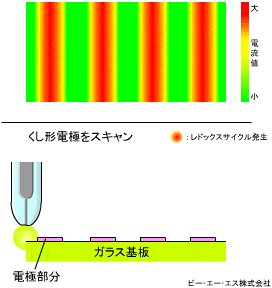 |
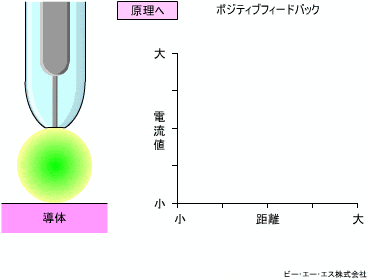 |
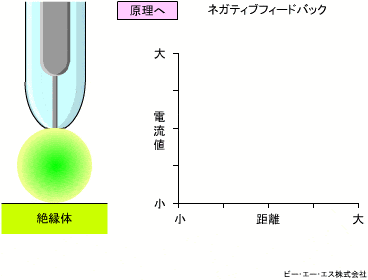 |
| マイクロポジショナー | |
| X,Y,Z解像度 | モデル900D: 8 nm |
| モデル920D: 1.6 nm | |
| X,Y,Z移動距離 | 50 mm |
| 大きさ(W×D×H) | 365 × 235 × 125 mm |
| バイポテンショスタット | |
| ポテンシャル範囲 | ±10 V |
| 電流範囲 | ±250 mA |
| 出力電圧 | ±13 V |
| 感度範囲 | 1×10-12 〜 0.1 A/V |
| 入力インピーダンス | 1×1012 Ω |
| 最小電位分解能 | 100 µV |
| 最大サンプリング速度 | 16bit @ 1 MHz |
| バックグラウンド電流 | < 20 pA |
| 電流分解能 | 0.01 pA |
| スキャン速度 CV | 1×10-6 〜 10,000 V/sec |
| パルス幅 CA, CC | 0.0001 〜 1,000 sec |
| パルス幅 DPV, NPV | 0.0001 〜 10 sec |
| 周波数 SWV | 1 〜 100 kHz |
| 周波数 IMP | 1×10-5 〜 1 MHz |
| iR補償機能 | ◯ |
| 対応OS | Windows™ 10※ / 11 |
| インターフェース | USB 2.0 |
| 大きさ(W×D×H) | 365 × 235 × 125 mm |
| 重さ | 3.6 kg |
| ステージ | |
| 駆動方式 | モデル900D: ステッパーモーター |
| モデル920D: ステッパーモーター+ピエゾ素子 | |
| 大きさ(W×D×H) | 240 × 280 × 280 mm |
※Windows™ 10 Sモードには対応しておりません。Sモードの場合は、解除を行ってください。
また、対応するのはマイクロソフト社がサポート中のバージョンのみです。
| 走査プローブテクニック | SPC: 表面パターン処理 |
| PAC: プローブ接近曲線 | |
| PSC: プローブ走査曲線(X,Y,Z) ・アンペロメトリー モード ・ポテンショメトリー モード ・インピーダンス モード ・定電流 モード ・定インピーダンス モード |
|
| SECM: 走査型電気化学顕微鏡 ・アンペロメトリー モード ・ポテンショメトリー モード ・インピーダンス モード ・定電流 モード |
|
| SISECM: Surface Interrogration SECM | |
| ZCCC: Zプローブ定電流コントロール |
モデル名をクリックするとWEB見積書に自動入力できます
| テクニック | 900D | 920D |
| CV | ● | ● |
| LSV | ● | ● |
| SCV | ● | ● |
| TAFEL | ● | ● |
| CA | ● | ● |
| CC | ● | ● |
| DPV | ● | ● |
| NPV | ● | ● |
| SWV | ● | ● |
| ACV | ● | ● |
| i-t | ● | ● |
| SHACV | ● | ● |
| DPA | ● | ● |
| DDPA | ● | ● |
| TPA | ● | ● |
| IPAD | ● | ● |
| BE | ● | ● |
| HDV | ● | ● |
| IMP | ● | ● |
| IMPT | ● | ● |
| IMPE | ● | ● |
| CP | ● | ● |
| CPCR | ● | ● |
| PSA | ● | ● |
| OCPT | ● | ● |
| SSF | ● | ● |
| STEP | ● | ● |
| ISTEP | ● | ● |
| RDE | ● | ● |
| Full CV Sim | ● | ● |
テクニック略称一覧
- CV: サイクリックボルタンメトリー
- LSV: リニアースイープボルタンメトリー
- SCV: 階段状ボルタンメトリー
- TAFEL: ターフェルプロット
- CA: クロノアンペロメトリー
- CC: クロノクーロメトリー
- DPV: 微分パルスボルタンメトリー
- NPV: ノーマルパルスボルタンメトリー
- SWV: 矩形波ボルタンメトリー
- ACV: 交流ボルタンメトリー
- i-t: アンペロメトリー
- SHACV: 第二高調波ボルタンメトリー
- DPA: 微分パルスアンペロメトリー
- DDPA: ダブル微分パルスアンペロメトリー
- TPA: トリプルパルスアンペロメトリー
- IPAD: 積分パルスアンペロメトリー検出
- BE: バルク電気分解/クーロメトリー
- HDV: ハイドロダイナミックボルタンメトリー
- IMP: 交流インピーダンス
- IMPT: インピーダンス/タイム
- IMPE: インピーダンス/ポテンシャル
- CP: クロノポテンショメトリー
- CPCR: クロノポテンショメトリー/タイム
- PSA: ポテンショメトリックストリッピング分析
- OCPT: Open Circuit Potential-Time
- SSF: スイープステップファンクション
- STEP: マルチポテンシャルステップ
- ISTEP: マルチ電流ステップ
- RDE: RDEコントロール
- Full CV Sim: CVシミュレーション
メッキへの応用
メッキ液を管理する方法としてはCVS(サイクリックボルタンメトリーストリッピング)法が利用されています。白金電極にメッキされる銅の剥離量からメッキ液の活性ならび品質管理が行えます。CVSにて測定されたメッキ液のボルタモグラムを示します。

メッキ液の剥離をチェックするために用いる電極としてグラッシーカーボン電極を用い、電極表面への銅の析出状態を比較したデータを示します。
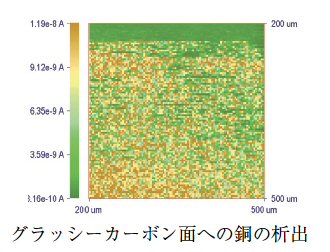
上記銅の析出データを3次元データに変換しました。メッキ液への添加剤の有無により、表面の平滑度の違いが分かります。
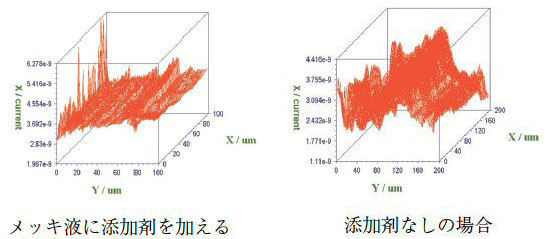
腐食への応用
サンプルとして、鉄と過酸化水素が鉄表面で反応して生じる水酸化イオン濃度の変化を、微小酸化インジウム電極を用いて、鉄表面の局所pH変化をポテンショメトリー法により観察した例を紹介します。